技術
セラミック多層パッケージ
1969年、京セラは米国フェアチャイルド社から、LSI用セラミック多層パッケージ(ハイデンシティパッケージ:HDP)の試作依頼を受けました。これは2枚のセラミック基板を重ね、92個のヴィアホールで接続するという、当時としては極めて先進的な技術でした。既に基礎技術の研究を進めていたことから、稲盛は「3カ月で作れる」と約束し、開発に取り組みます。
そのような無謀とも思える約束をした背景には、稲盛が以前からアメリカのテキサス・インスツルメンツ社(TI)を訪問し、ICを保護する新しいパッケージの試作依頼を受けていた経験がありました。アメリカで新たなセラミックス技術が芽生えつつあること、そして、いずれはそれが巨木へ育つことを直感した稲盛は、帰国後すぐにテープ成形法や積層法の開発に着手しました。この先見性と準備が、短納期という難題を可能にしたのです。
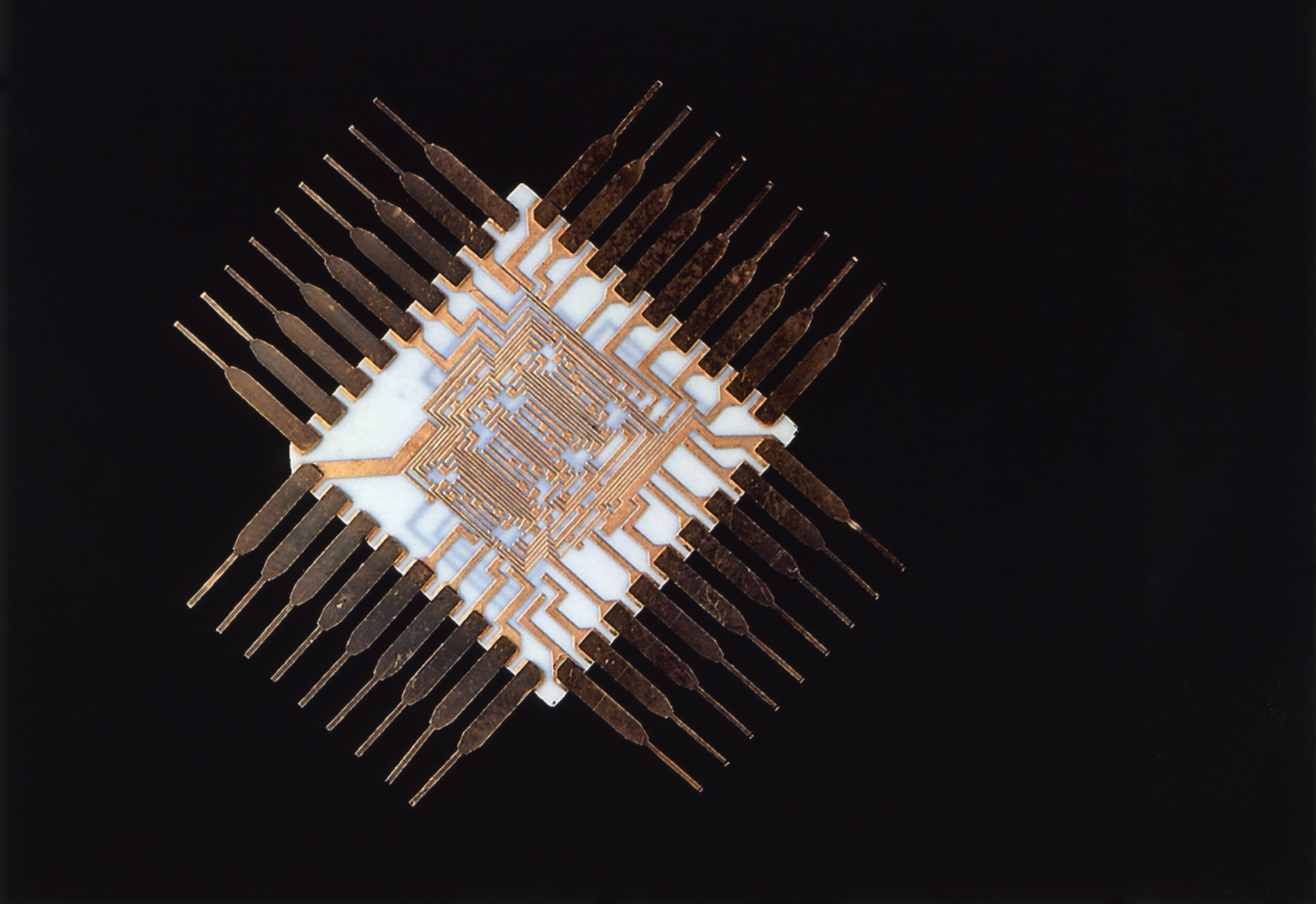
【ハイデンシティ(HD)パッケージ】
しかし、世界初のセラミック多層パッケージ開発は困難を極めました。テープの強度や寸法安定性、ヴィアホール加工、微細回路印刷、積層など課題は山積し、設備も不十分。海外から機械を調達するなど、稲盛と開発陣は寝食を惜しんで挑戦し、ついに試作品を完成。約束通り20個を納め、フェアチャイルド社から高く評価されました。
最終的にHDPは設計変更で採用されませんでしたが、開発過程でテープ成形や積層、同時焼成など多くの技術的飛躍を遂げます。これらは後にアメリカン・マイクロシステムズ(AMI)社やインテル社から大量受注を得る礎となりました。
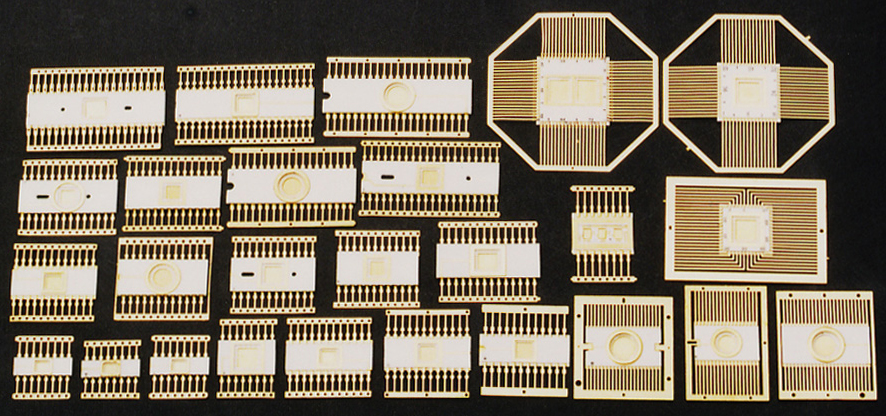
【初期のセラミック多層パッケージ】
同年8月、AMI社から電卓用ICパッケージ100万個の大量注文が舞い込みます。稲盛は設備投資に慎重でしたが、半導体の将来性を確信し、税引前利益の3~4割にあたる大型投資を即断。米国メーカーが将来性に確信が持てず及び腰になる中、京セラは新工場と生産ライン整備を決断し、世界的ファインセラミックメーカーへ躍進する転機となりました。
量産化も難航し、設備不足や歩留まりの低さから鹿児島工場(現 鹿児島川内工場)は赤字続き。稲盛は現場に頻繁に足を運び、社員や幹部と改善に奔走しました。後の経営陣となるメンバーたちもこの困難を支えました。1970年末には歩留まりが改善し、1971年4月には月産100万個体制を実現。不況下でも電卓需要の追い風を受け、京セラの業績は伸長しました。 稲盛和夫の決断力や先見性、現場主義と粘り強い姿勢が、京セラを世界有数の半導体パッケージメーカーへと導きました。この経験は、同社の成長とグローバル企業への飛躍を支える原動力となったのです。