課題:部品搭載面の発熱対策
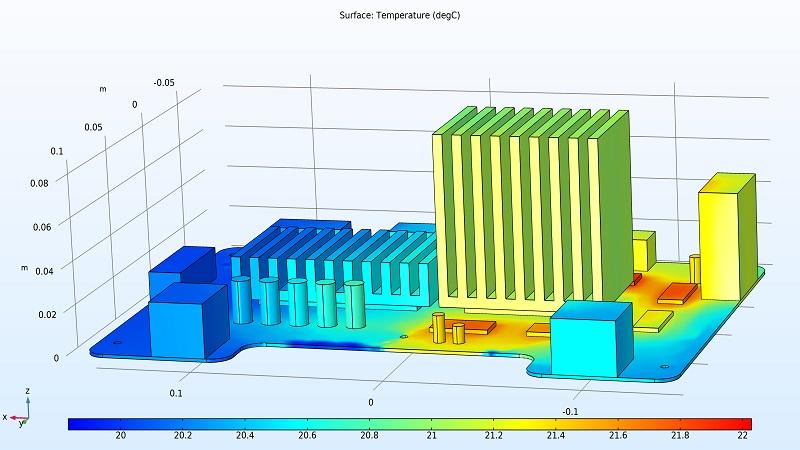
プリント配線板上の発熱部品を対象に、熱分布を可視化します。プリント配線板の熱伝導特性を考慮した基板の熱分布と、筐体を含む熱分布の解析が可能で、部品配置の最適化やヒートシンクとして機能する基板のベタパターン、VIA数の最適化が図る事が可能です。
主な対応可能項目
-
熱解析
・多ピンBGAのVIA周囲で発生する電圧降下の事前検証と最適化
・回路の多電源化に伴う電源層の検証と最適化
・電源供給元からICの電源元までの経路におけるDC抵抗を算出し、規定の電圧変動以内とするための最適化
・ボード、パッケージ、チップの接続端子数の最適化
【シミュレーション事例】基板上の温度分布、筐体を含む温度分布
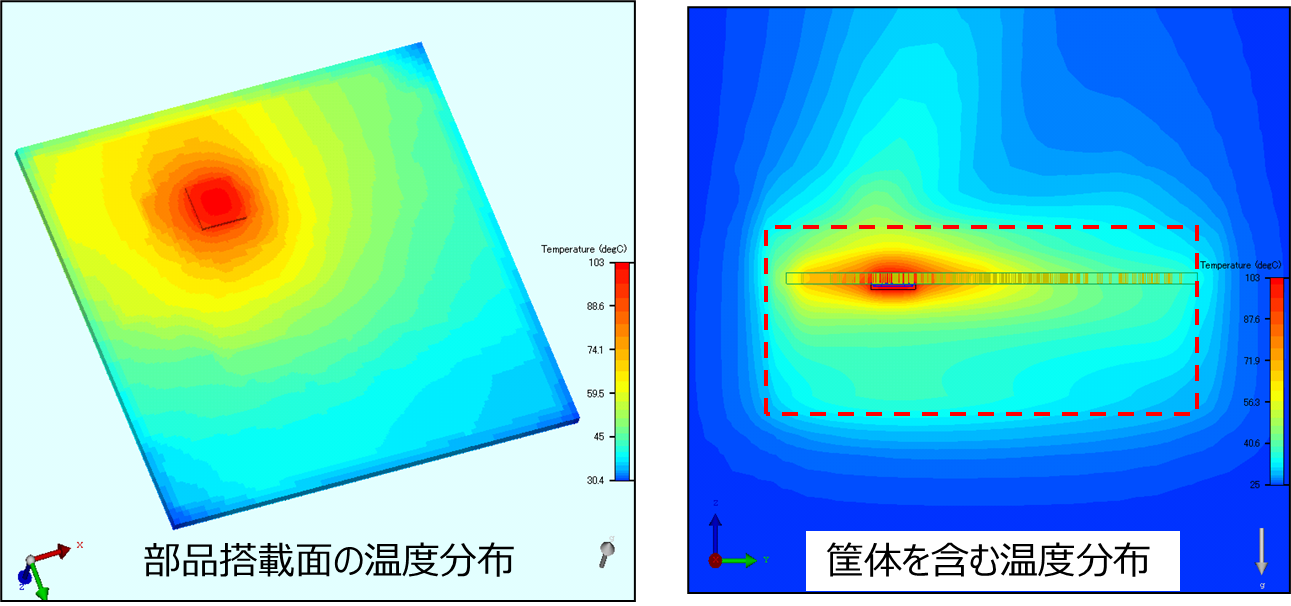
・設計段階で「放熱を考慮した最適部品配置」や「導体配置の検討/ビア数の検討」等の熱対策を検討します
・電気特性(SI/PI/EMI)とのトレードオフを検討します
関連事例
熱シミュレーションの導入事例をご紹介します。