業界最先端のデザインルールに適応したビルドアップサブストレート
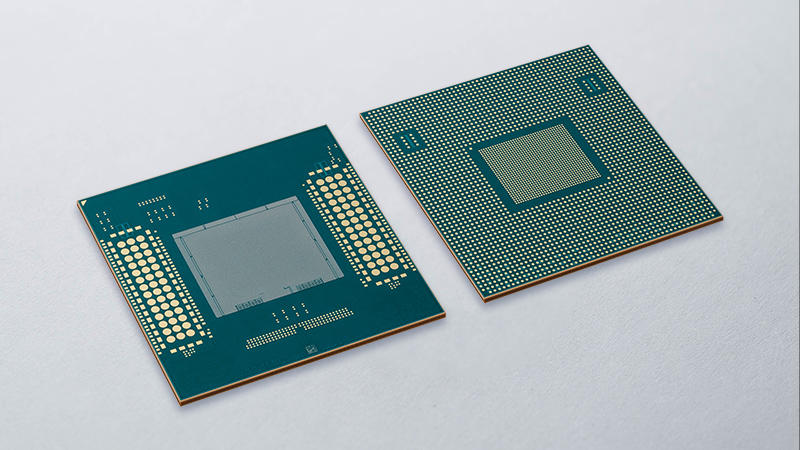
京セラのFC-BGA基板はファインなデザインルールを可能にした高信頼性の半導体用高密度有機パッケージ基板です。
業界最先端クラスのビルドアップ基板の設計技術、加工技術により9,000ピン以上のI/Oを有するハイエンドフリップチップLSIに対応した高品質、高性能なビルドアップ構造の有機パッケージを提供しております。
特長
-
最先端クラスの微細配線ルールでLine/Space:9μm/12μmを実現
-
レーザーによる小径ビア形成で高密度配線を実現
-
信頼性に優れた熱硬化性エポキシ樹脂を採用
-
実装ニーズに合わせた表面処理への対応が可能(Ni/Pd/Au、Solder pre-coat、etc)
-
鉛フリー、ハロゲンフリーなどのグリーン仕様にも対応
断面構造
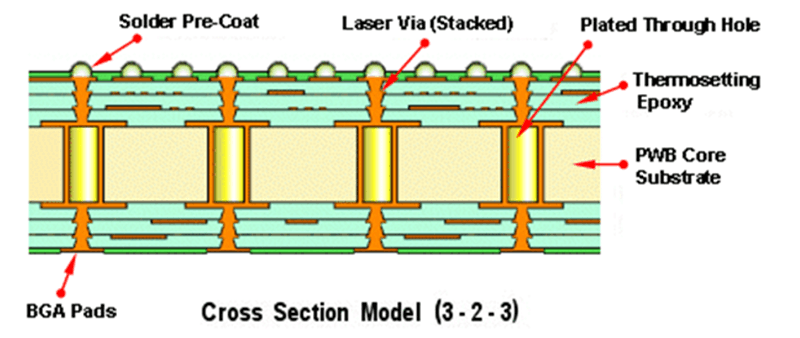
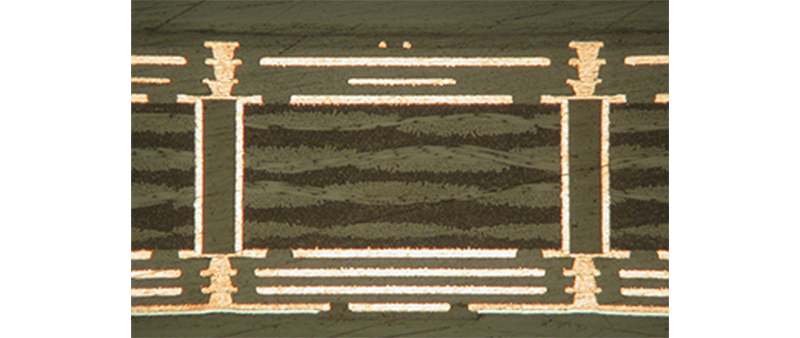
デザインルール
| 項目 | 仕様 (Unit: μm) | 備考 |
|---|---|---|
| 層構成 | Up to 10-n-10 | 最大ビルドアップ積層実績 |
| ビルドアップ層の配線幅/間隙 | 9/12 | 最小 |
| ビアランド径 | 85 | 最小 |
| コア層の配線幅/間隙 | 30/45 | 最小 |
| フリップチップ パッドピッチ | 100 | 最小 |
製品用途
- ハイエンドサーバMPU
- ネットワークルーター/スイッチ向けASIC
- 車載向けSoC
- 高性能ゲーム機向けASIC
- FPGA
- グラフィックプロセッサなど