京セラでは、「ウエハのUBM加工(めっき加工)」「ウエハのバンプ加工」の後工程として、以下の工程まで対応が可能です。
- ウエハのバックグラインディング
- ダイシング
- 梱包(トレイ詰め、テープ&リール形態)
その際、弊社でハンドリングを行うことも可能です。
お気軽にご要望をお申し付けください。
後工程一覧
BG(back grinding)工程

BG工程
ウエハの裏面を研削して厚みを薄くする工程です。
背景として、1枚のシリコンウエハから半導体チップの取り数を多くして単価を下げるため、ウエハサイズは大口径化してきました。大きなウエハの形状を保つためにはある程度の厚みがないと垂れてしまうので厚みがあったのですが、一方でチップを高密度実装に使うためには出来るだけ薄い方がよく、結果裏面研削という工程が必要となりました。
回路面(表面)をテープで保護し、ダイヤモンドホイールを高速回転させ、砥石で裏面を削ります。
ダイシング(dicing)
ダイ(シリコンダイ)とはウエハから切り出されたチップ1個1個のこと。ウエハをチップ形状に切り出してチップ化する工程をダイシング工程と言います。ダイシングは切断方式により下記3つの種類があります。
①ブレード
最も一般的な方式で、回転するブレード(砥石)で切断します。
※右写真はブレード切断の様子
②レーザーアブレーション
レーザーを照射しウエハを昇華・蒸発させて切断します。
③レーザーステルス
ウエハ内部にレーザーで改質層を形成し、外力で切断します。

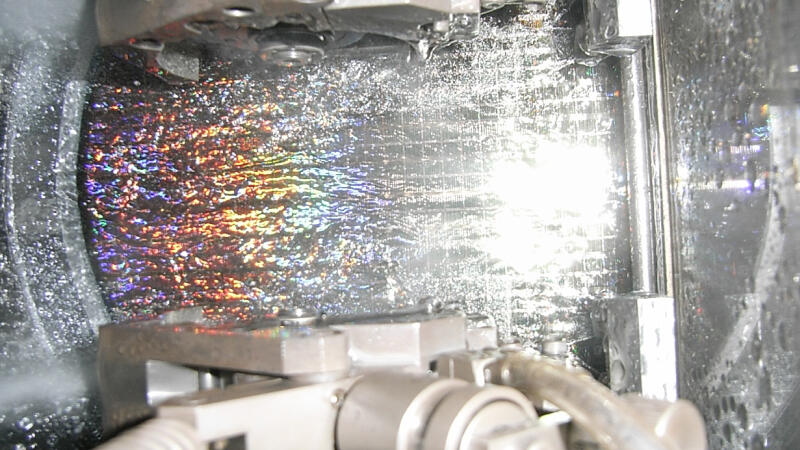
梱包

必要とされる様々な形態での梱包・納入に対応させて頂きます。
①テープ&リール
②トレイ詰め
③リング形態:①②がチップ個片での梱包・納入なのに対し、リング形態はウエハの状態で納入となります。
※ダイシングはされておりチップ個片がウエハの形になっている状態です。
よくあるご質問
関連する情報