解決したい課題:発熱した素子からの放熱
発熱した素子の熱がデバイス内にこもると、素子への負荷がかかり故障などの原因となるため、効率的に放熱する必要があります。
素子と接触するパッケージに熱伝導率の高い材料を使用することで、素子からの発熱を効率的に放熱する事が可能となります。
京セラは、銅などの熱伝導率が高い金属材料を接合できる技術を保有しており、金属のヒートスプレッダー(HS)を設けたパッケージのご提案も可能です。
ヒートスプレッダー付きパッケージの事例
以下にヒートスプレッダー付きセラミックパッケージの構造の一例を示します。他にも様々な構造を製造可能です。材料毎にパッケージデザインの最適化が必要ですので、詳しくはお問い合わせください。
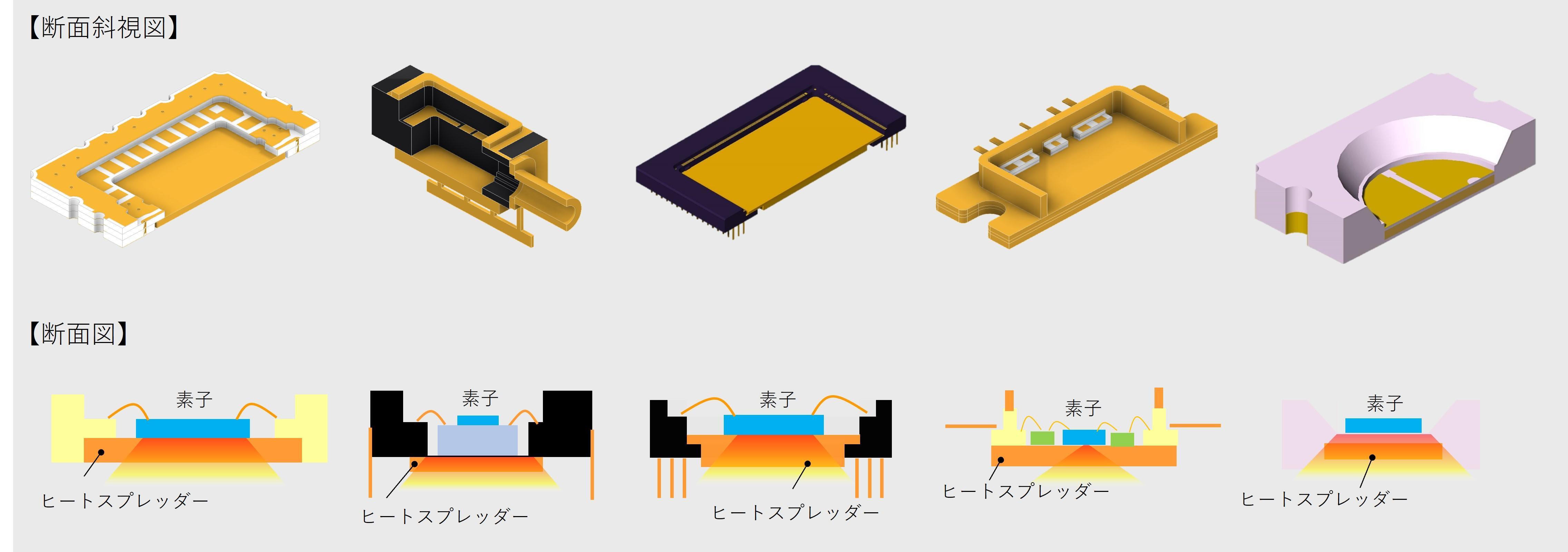
セラミックスと接合可能なヒートスプレッダー材料の材料特性表
O.F.H.C.銅、銅タングステン(CuW)、銅モリブデン(CuMo)など ヒートスプレッダー材料の材料特性表を示しています。※O.F.H.C.:Oxygen Free High Conductivity

(*)CuMo、CPC141、CPC232の熱膨張係数は、圧延方向により値が変わる場合がございます。
(**)熱抵抗:計算値による。発熱体サイズ1.0×1.0mm、ヒートスプレッダー厚み1.0mm、接合材による損失は含まない。
熱抵抗算出簡易式はこちら
(**)熱抵抗:計算値による。発熱体サイズ1.0×1.0mm、ヒートスプレッダー厚み1.0mm、接合材による損失は含まない。
熱抵抗算出簡易式はこちら
- 上記の材料物性値は代表値です。材料や工程の改善・変更により、値が変わる場合がございます。
- 「CPC」は株式会社アライドマテリアルの登録商標です。(CPC:Cu-Mo複合材の上下にCu層を備えた積層構造の放熱基板)
- 「KYCM」と「CM360」は京セラ独自の材料コードです。
- 「KYCM」は京セラ株式会社の登録商標です。
ヒートスプレッダーの特性図(熱伝導率×熱膨張係数)
上記表のヒートスプレッダー材料について、熱伝導率と熱膨張係数の関係を以下図に示します。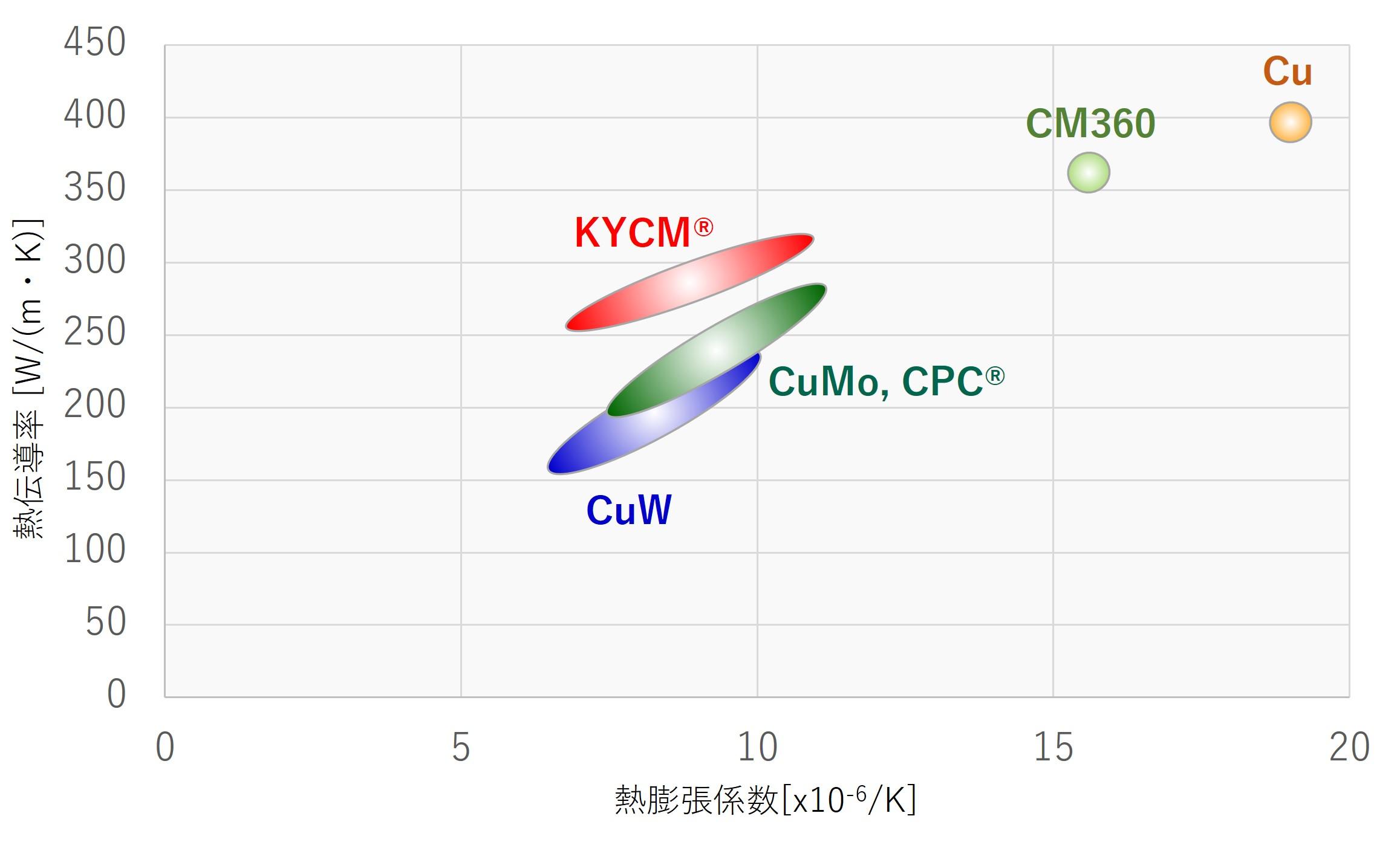
「素子の放熱」を含む熱マネジメントのヒントはこちら
資料をダウンロード関連するその他の課題
関連する課題解決策
関連材料
関連するテーマ・トレンド






