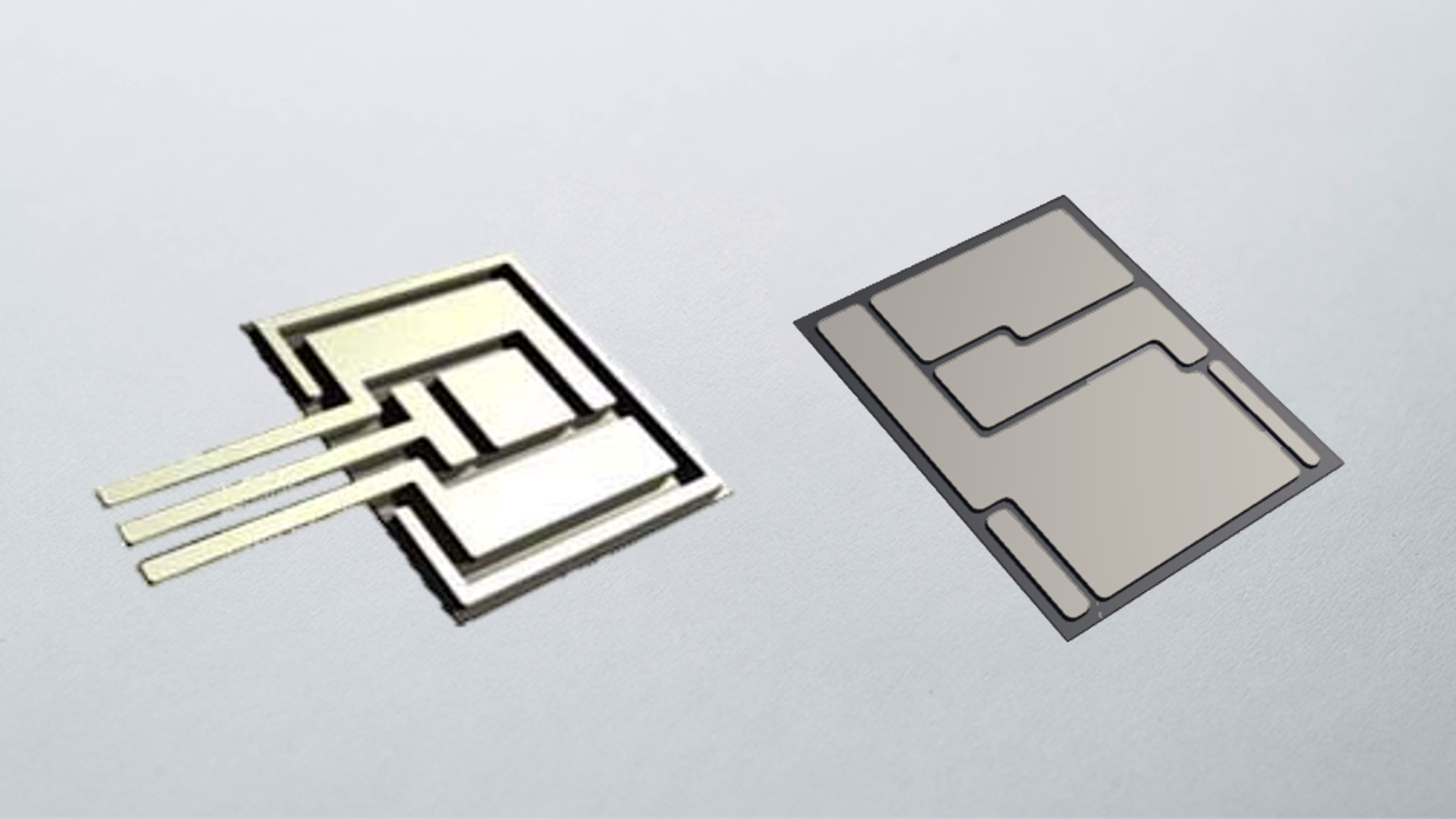
京セラは、Cu板と窒化ケイ素基板を積層した産業用パワーモジュール向け絶縁放熱回路基板を提供しています。 アルミナに比べて、高強度・高靭性・高熱伝導率である窒化ケイ素を絶縁体に使用しており、活性金属接合法(Active Metal Brazing:AMB)を用いて銅板とセラミックスを接合することで、高信頼性を実現しています。
特長
高耐電圧
高熱伝導
高靭性
日本製
京セラのパワーモジュール向け絶縁放熱回路基板は、高耐電圧・高靭性の窒化ケイ素基板に活性金属接合法(Active Metal Brazing:AMB)を用いてCu板を接合しており、高信頼性を実現しています。
AMB(Active Metal Brazing)
AMB基板とはActive Metal Brazing(活性金属接合)基板の略称です。Cu導体と絶縁体であるセラミックスを活性金属を含むろう材で接合する技術を用います。
直接Cuを接合した安価なDBC(Direct Bonded Copper)基板と比較し、 活性金属による強固な接合で温度サイクル試験において高い信頼性を持ちます。
AMB(活性金属接合)とDBC(直接接合)の比較
京セラのAMB
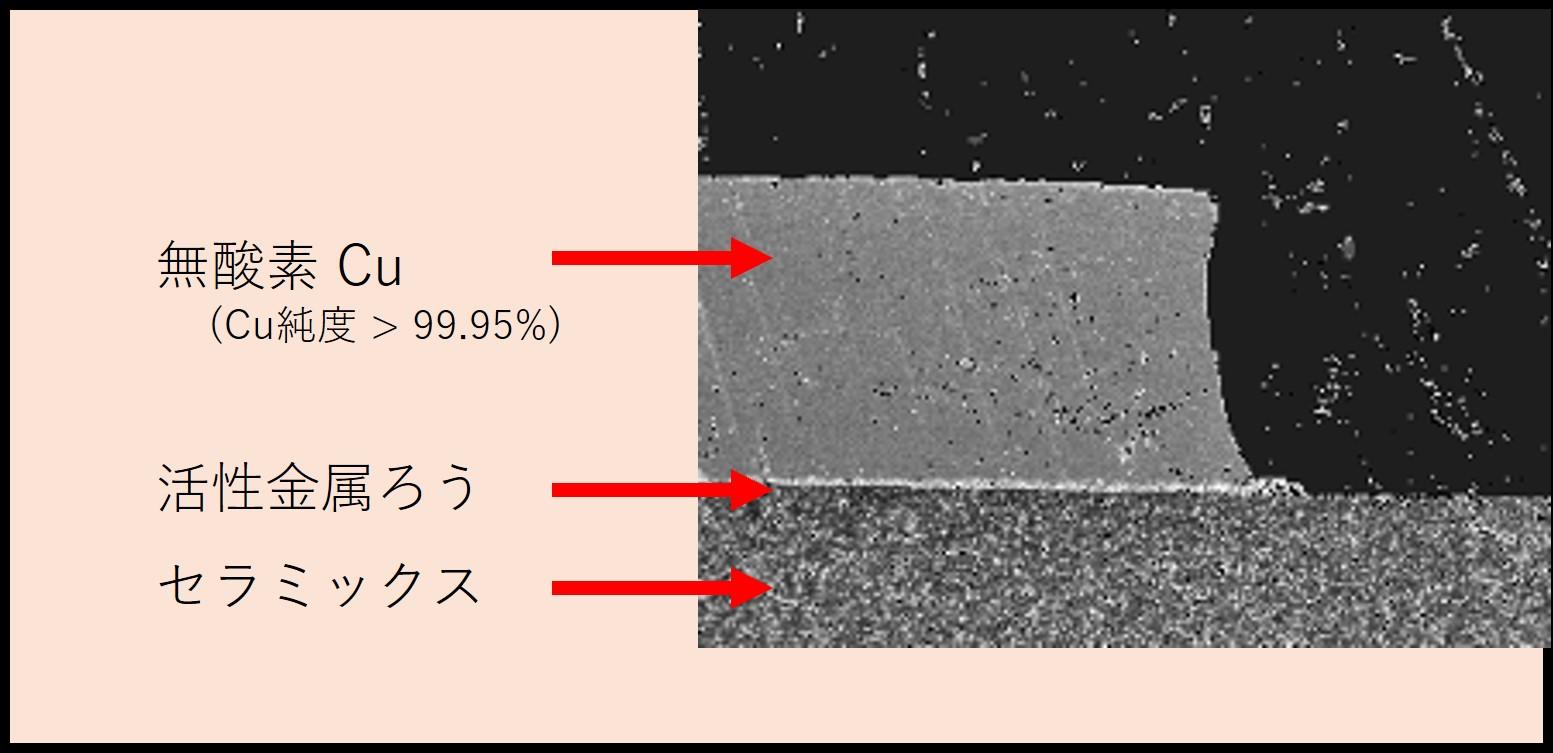
長所
- 高信頼性 活性金属ろう材による強固な接合
- 厚Cu対応 高強度セラミックス(Si3N4)
- プロセスコストが高い
一般的なDBC
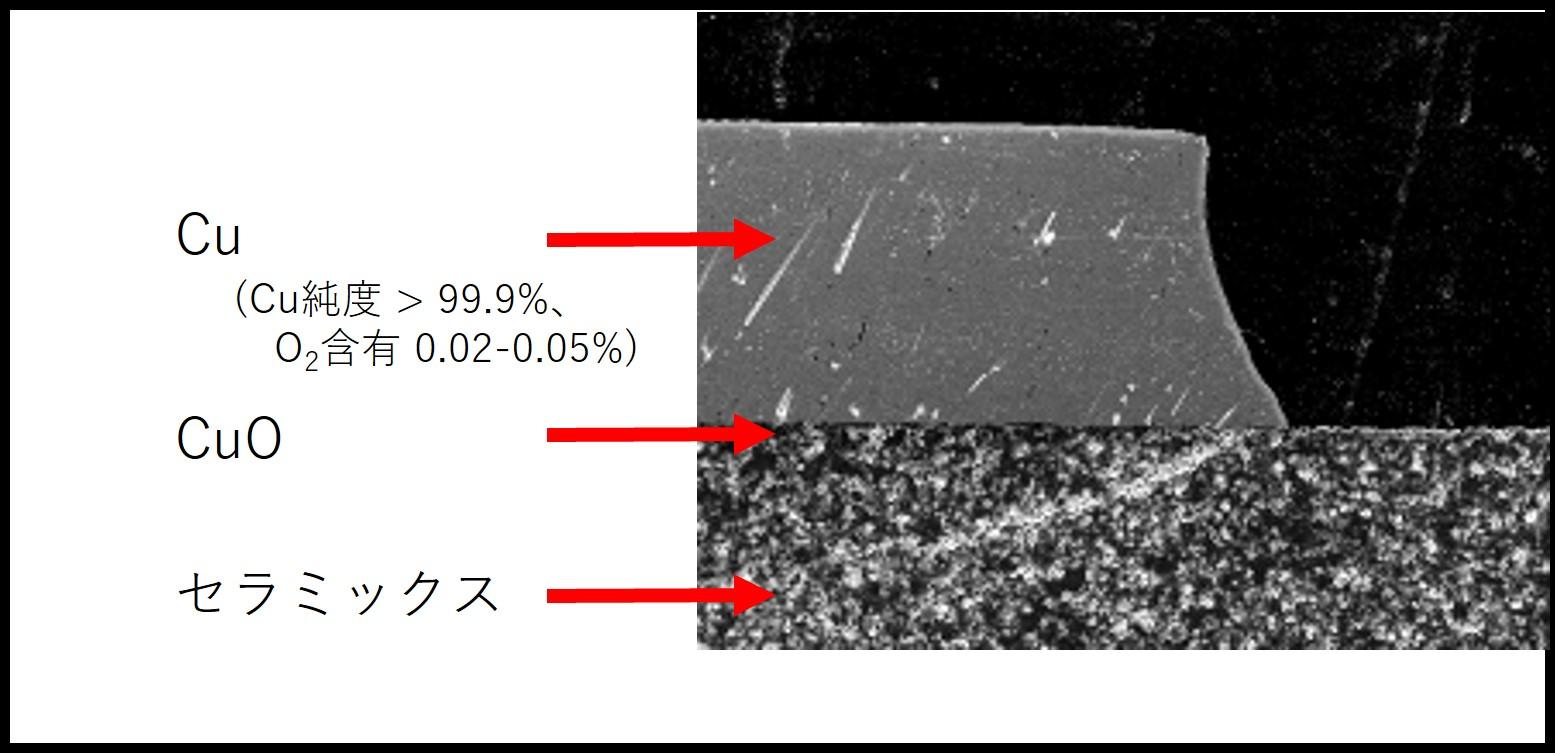
長所
短所
- プロセスコストが安い
短所
- 信頼性が低い (残留応力大、接合強度弱)
窒化ケイ素を使用したAMB基板の高信頼性
窒化ケイ素は窒化アルミニウムと比較して抗折強度が高い材料です。このため、厚Cuを接合し、セラミック基板を薄くすることで、高放熱の実現ができます。さらに、以下試験結果のように高信頼性を確保することが可能です。
窒化ケイ素・窒化アルミニウム・アルミナを用いたAMB基板の温度サイクル試験結果
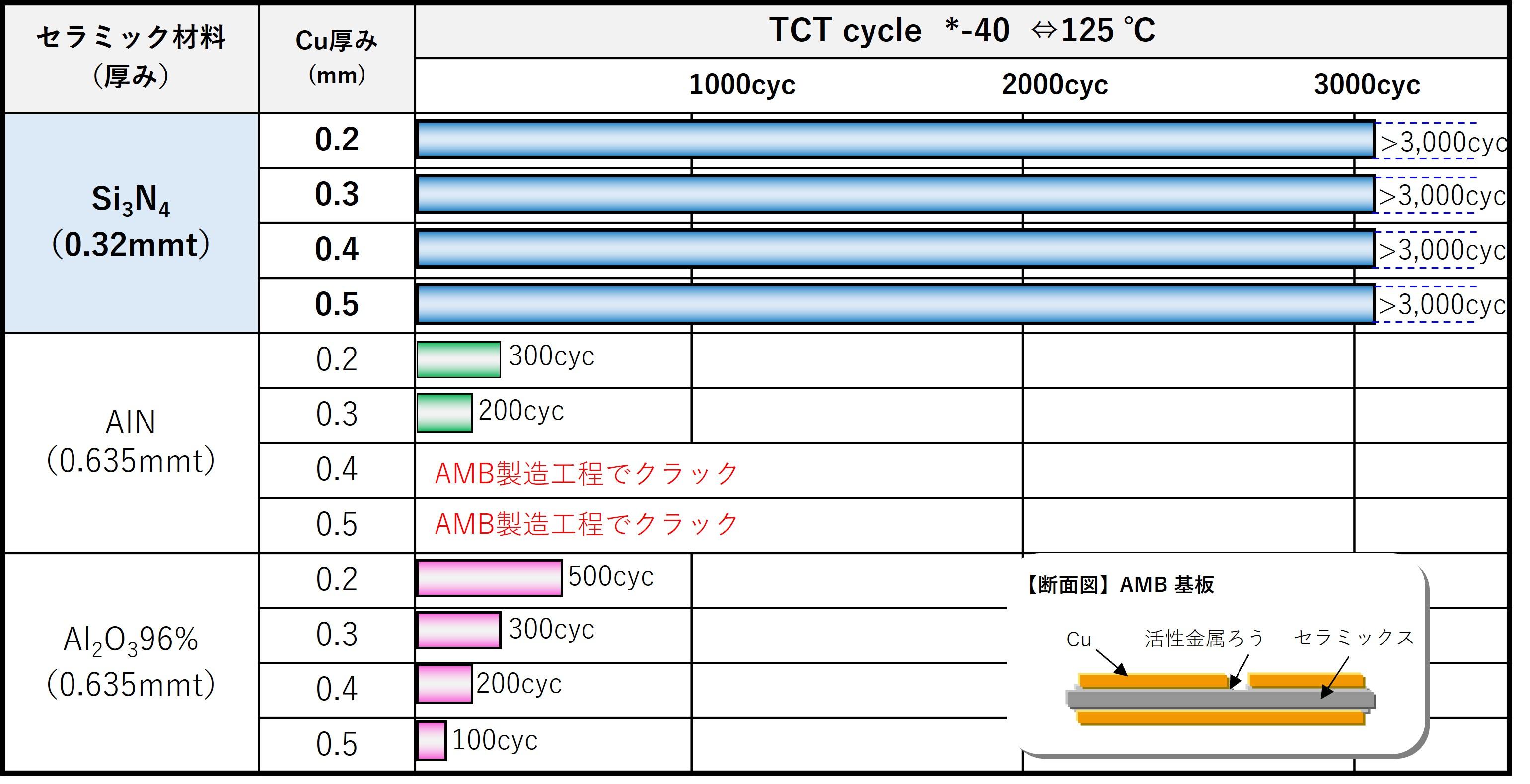
※京セラによる測定
- 基板外形サイズ:30mm x 40mm
- 基板構造: Cu/(Si3N4 or AlN or Al2O3)/Cu; 表: Cu 配線、 裏:Cu 配線なし
高耐電圧
測定状態概略図

① 窒化ケイ素(SN460)基板外寸(48×38mm)をCu板(29×32×0.5mmt) で挟み込み。
②測定条件:気中、カットオフ電流0.5mA、印加時間1分
③短絡するまで電圧を上げる。(0.5kV刻み)
②測定条件:気中、カットオフ電流0.5mA、印加時間1分
③短絡するまで電圧を上げる。(0.5kV刻み)
絶縁耐圧測定結果
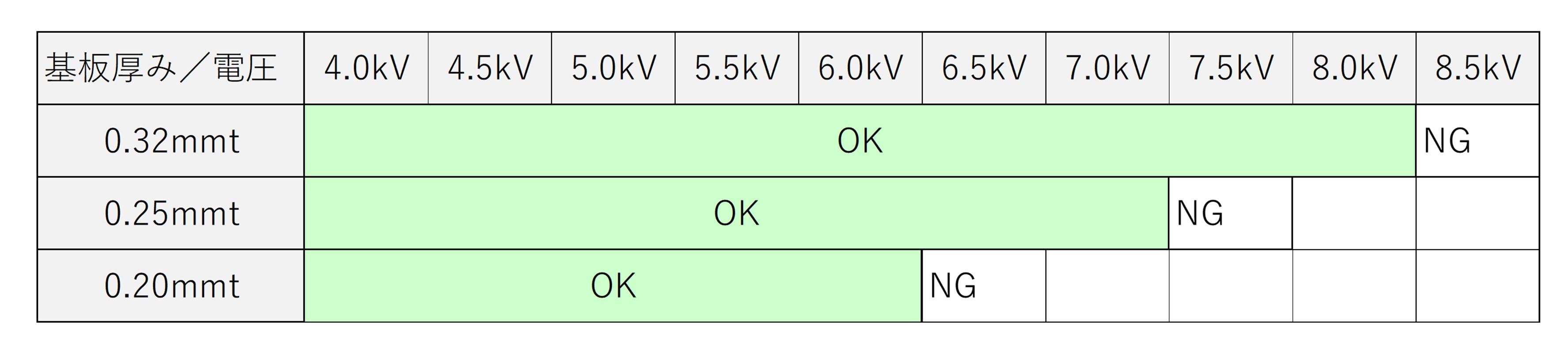
0.32mmでは8kV、0.25mmでは7kVの絶縁耐圧を確認(参考値)















