解決したい課題:目的に合わせた二次実装形態の選択
二次実装(パッケージングされたデバイスをPCBに搭載する工程)にはさまざまな形態があり、デバイスの仕様(サイズや信頼性など)に合わせて二次実装形態を決める必要があります。
セラミックパッケージは、設計自由度が高い・異材料接合可能といった特長や技術を活かし、さまざまな二次実装に対応可能です。
また、LCC(リードレスチップキャリア)においては、側面にキャスタレーションを設けることが可能です。
キャスタレーションにメタライズすることにより、はんだ接合時にフィレットを形成し二次実装信頼性を高めることができます。
※キャスタレーション:基板の側面に切り欠きを加工したもの
二次実装に関する信頼性向上のヒントはこちら
資料をダウンロード二次実装形態の事例
挿入実装型
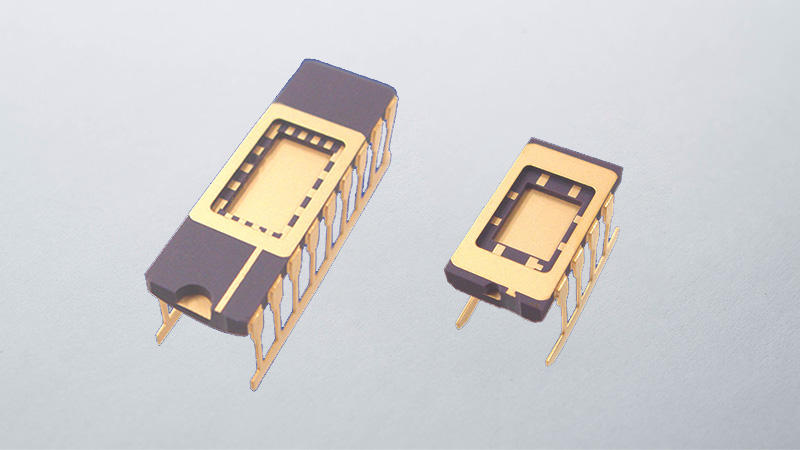
C-DIP
(Ceramic Dual Inline Packages)
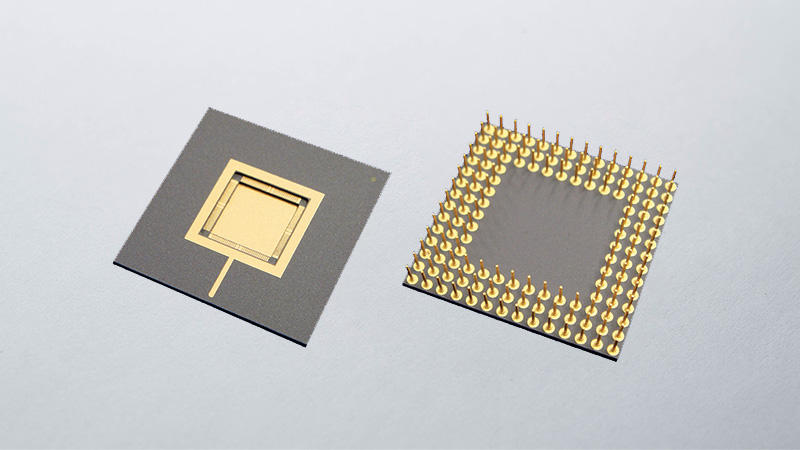
C-PGA
(Ceramic Pin Grid Array Packages)
表面実装型
リードあり
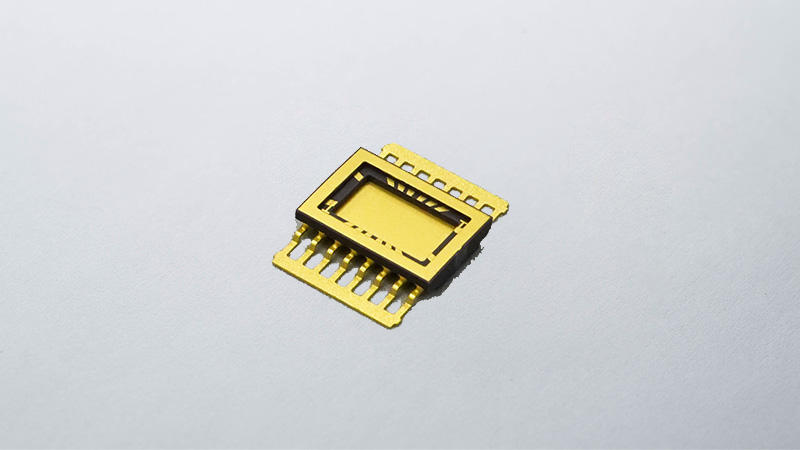
C-SOP
(Ceramic Small Outline Packages)
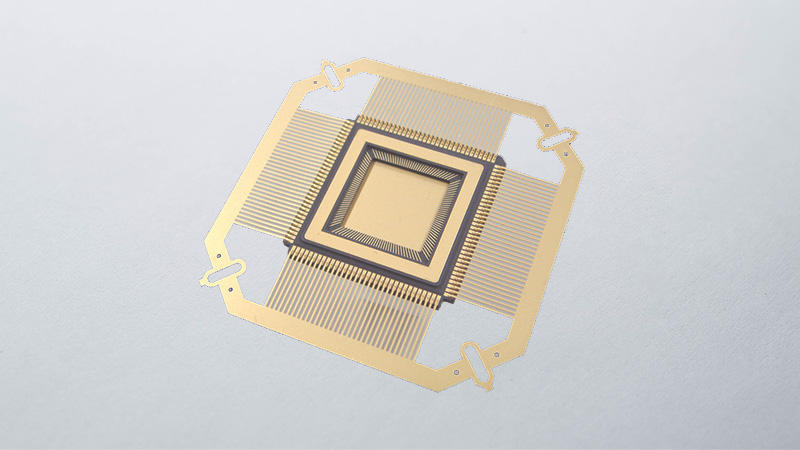
C-QFP
(Ceramic Quad Flat Packages)
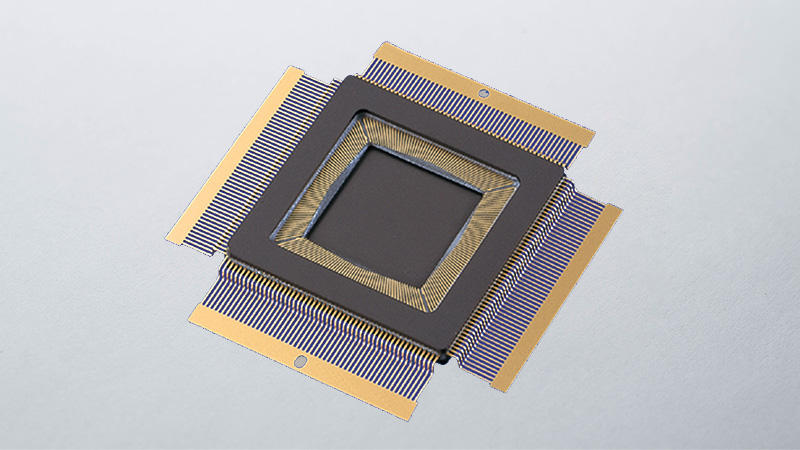
CERQUAD® Packages
※「CERQUAD」は京セラ株式会社の登録商標です。
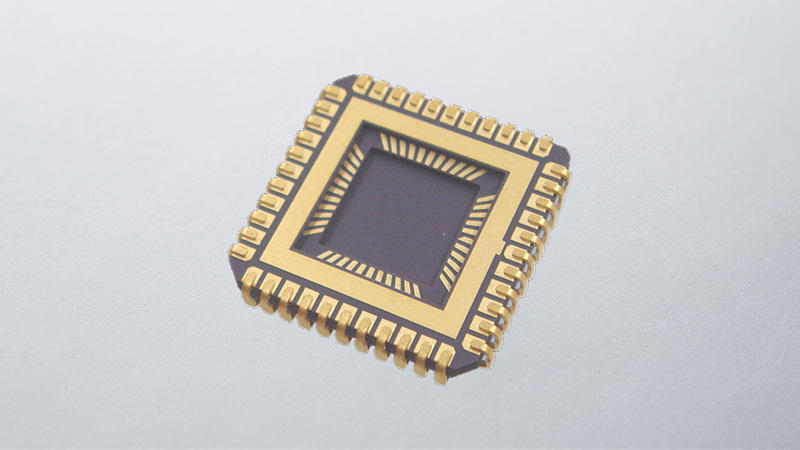
C-QFJ
(Ceramic Quad Flat J-Leaded Packages)
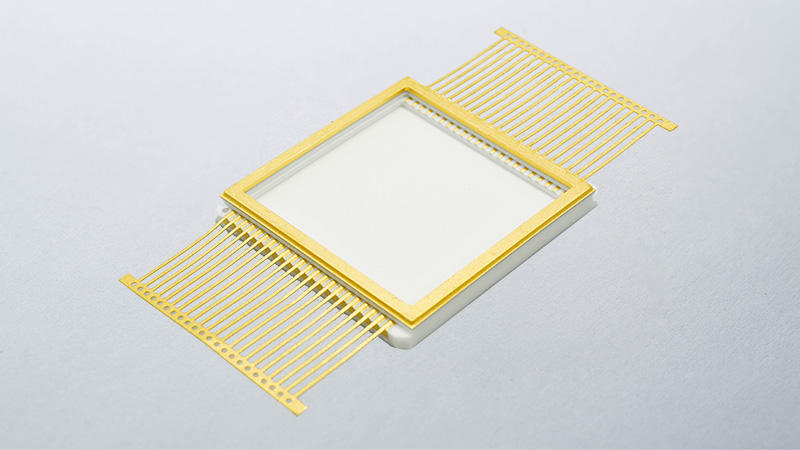
Flat Packages
リードなし
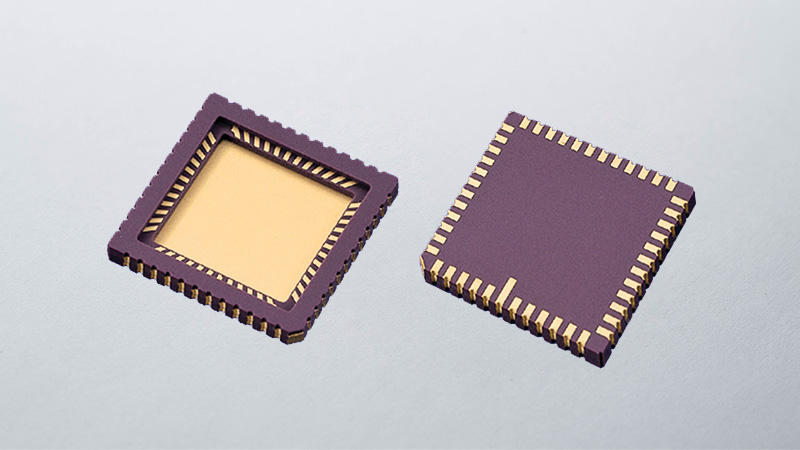
C-QFN
(Ceramic Quad Flat Non-Leaded Packages)
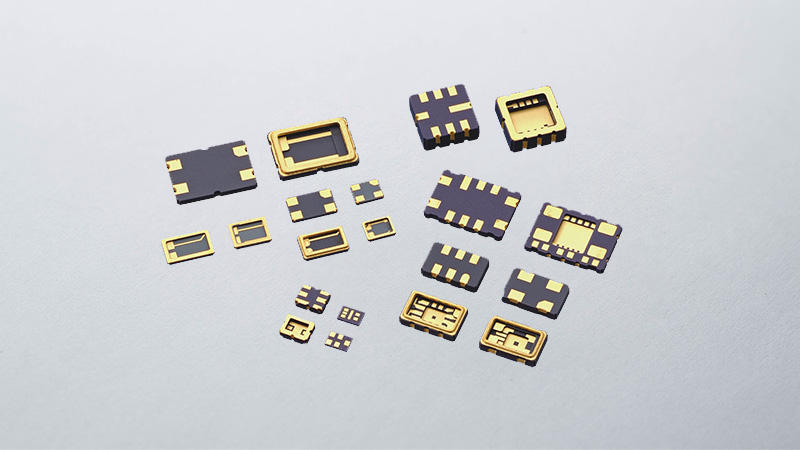
電子デバイス用表面実装
セラミックパッケージ
LCC(リードレスチップキャリア)のキャスタレーションについて
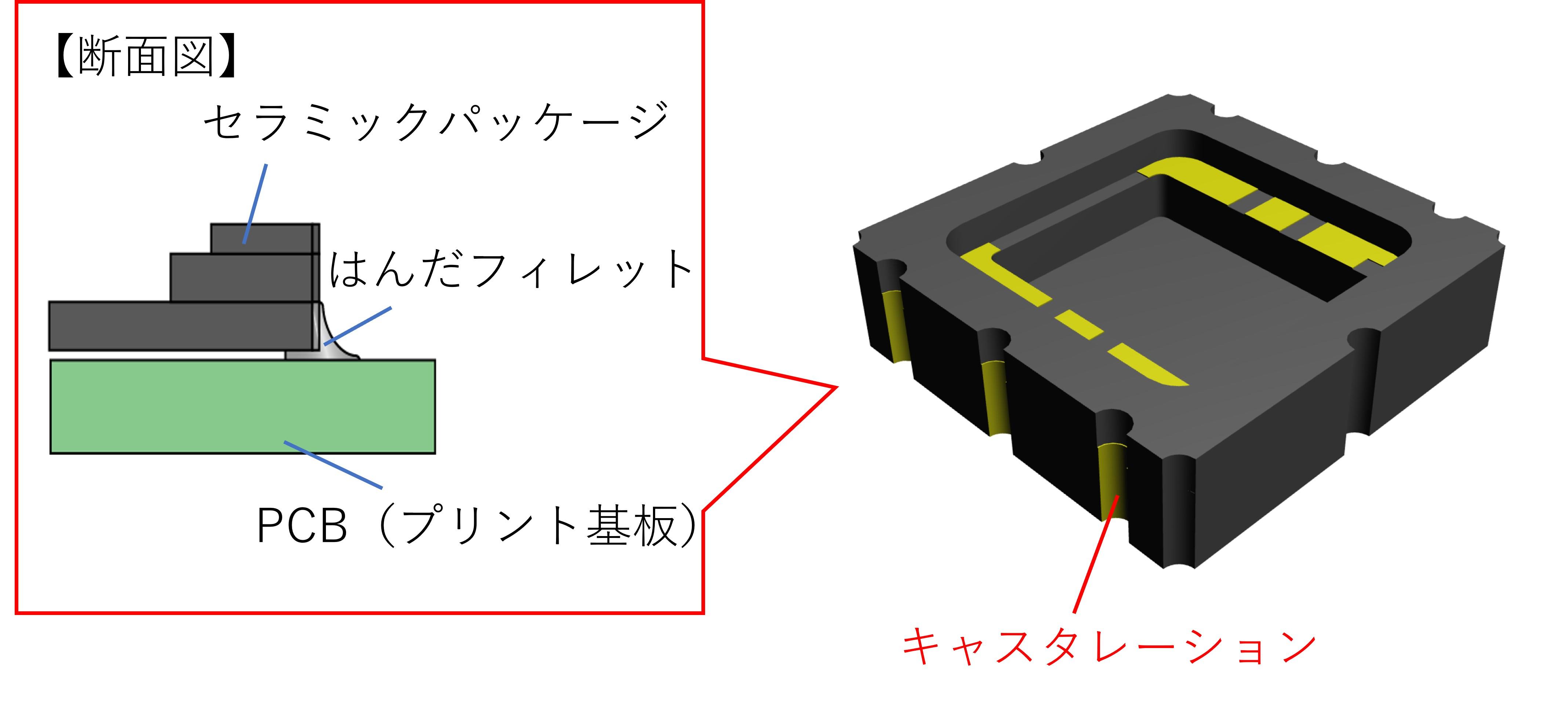
LCCにおいては、側面にキャスタレーションを設けることが可能です。
キャスタレーションに配線を設けることで、はんだ接合時にフィレット形成が可能となります。
これにより以下の利点があります。
①二次実装接合強度アップ
②はんだ実装状態を目視確認可能






