半導体パッケージ/パッケージングとは
半導体パッケージは、ICチップなどを保護し、外部と電力や電気信号の入出力を行うための「ケース」の事を言います。
金属、プラスチック、ガラス、セラミックスなどの材料で作られています。
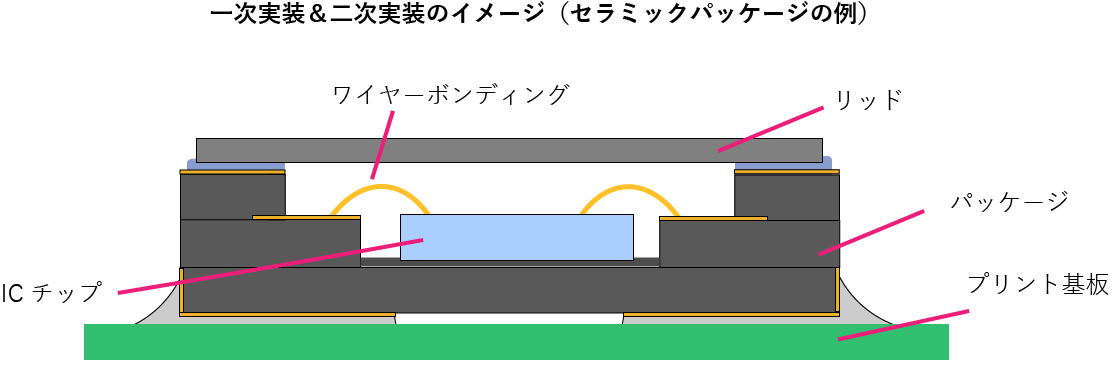
半導体パッケージの役割
- 外部環境からICチップを保護する (水蒸気、ダスト、光、電磁波など)
- ICチップを機械的に保護する
- ICチップからの電気信号を入出力/絶縁する
- ICチップから発生する熱を外部へ放散させる
パッケージングについて
一次実装とは
ICチップをパッケージに搭載すること。
一次実装のイメージ


二次実装とは
パッケージングされたデバイスをプリント基板に搭載すること。
パッケージとプリント基板の物理的な固定及び電気的接合を行う。
二次実装のイメージ(表面実装の例)

パッケージ形状
ピン挿入タイプのDIP(Dual Inline Package)、PGA(Pin Grid Array)、リード付のQFP(Quad Flat Package)、表面実装タイプのQFN(Quad Flat Non-leaded Package)、BGA(Ball Grid Array)、CSP(Chip Size Package)、LCC(Leadless Chip Carrier)等、二次実装の形態によってパッケージの形状も様々あります。
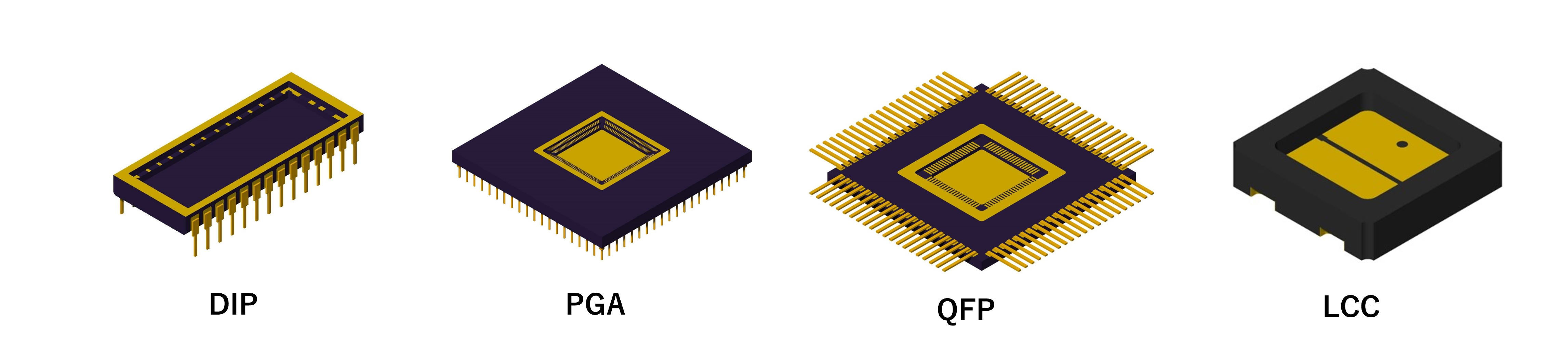
※各種標準品を取り揃えています。こちらからご参照ください。
セラミックパッケージとは
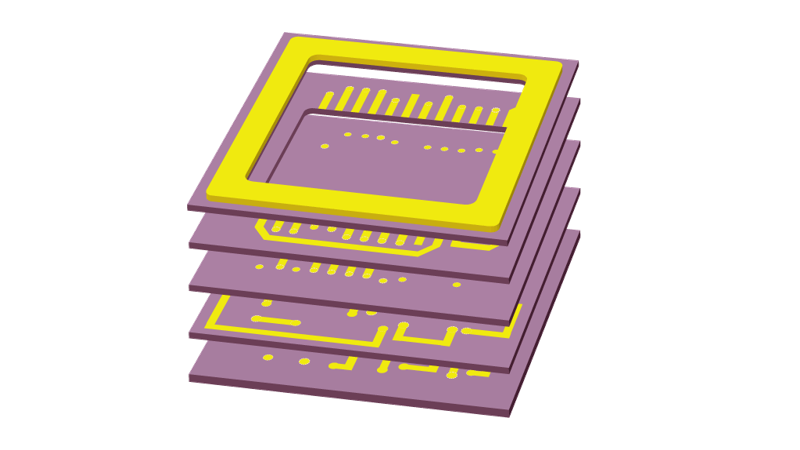
セラミックパッケージの多層構造図
半導体パッケージの材料には、用途や特性などによって有機(プラスチックなど)、無機(セラミックスなど)、金属が使い分けられています。 セラミックパッケージは、ファインセラミックス(※)で作られたパッケージの事です。
京セラのセラミックパッケージは、高強度、高熱伝導率、低熱膨張、デザインの多様性などの優位点を持ち、大量生産が必要な製品から高信頼性が求められる精密機器に至るまで、幅広い分野で採用されています。
製品用途事例はこちら
※セラミックスは、「非金属・無機材料で、その製造工程において高温処理を受けたもの」を指します。陶磁器、ガラス、セメント、レンガ、ほうろう、黒鉛製品もこの定義に当てはまりますが、特に高い材料特性や寸法精度を持ったものをファインセラミックスと呼びます。
京セラのセラミックパッケージの特長
-
設計自由度高1層ずつ加工したものを積層する工法の為、電気配線を含めた3次元構造が容易に実現可能。
小型化、低インダクタンス化、キャビティ構造(箱形状)の形成、素子に合わせた設計(端子配列の自由度実現)などが可能です。※セラミックパッケージの製造工程はこちら -
材料バリエーション多種多様なセラミック材料を有しており、熱伝導率、熱膨張率、高周波特性など、実現したい特性に合わせた材料の提案が可能です。※材料特性表はこちら
-
電気的特性3次元配線と構造の工夫により、電気特性を考慮した設計が可能です。
また、低tanδのLTCC材料を保有しています。※LTCC材料の詳細はこちら -
熱的特性
-
機械的特性セラミックスは強度、剛性、ヤング率が高い材料です。高強度により、壁幅が薄いキャビティが形成可能なため、中空構造のパッケージを小型化することができます。
-
実装バリエーション一次実装、二次実装共にさまざまな形態の実装に対応することができます。・一次実装:ワイヤーボンディング、フリップチップボンディングなど・二次実装:LCC、QFP、PGA、DIP、BGA など※各種標準品はこちら
-
小型、薄型各層で配線を施した後に積層するため、内層配線を形成することができ、小型化が可能です。
さらに、剛性が高いため、薄くしても反りにくいという特長があります。また、層ごとに異なる位置に貫通導体(ビアホール)を設けることが標準仕様で可能です。※高強度材料はこちら