解決したい課題:実装(一次実装/二次実装)時の熱応力の緩和(信頼性向上)
実装の際に、材料間の熱膨張係数差が大きいと、加熱・冷却により熱応力が発生し、実装部が破断してしまうなどの問題があります。
熱応力を緩和しデバイスの信頼性を向上させるには、素子とパッケージ/パッケージとマザーボードの熱膨張係数を近づけることが重要です。京セラは多様なパッケージ材料をラインアップしており、素子やマザーボードの材料に合わせた提案が可能です。
多様なパッケージ材料をラインアップ
京セラは、Siに近いものからマザーボードに近いものまで、さまざまな熱膨張係数を持つ材料を幅広くラインアップしています。
お客様のご要望に合わせて、最適な材料をご提案いたします。
セラミックパッケージ材料の熱膨張係数

【参考情報】GL570とSiとの熱膨張のマッチングを確認したシミュレーションデータ
京セラで最も採用実績のある材料 A440(アルミナ)と、熱膨張係数がSiに近い材料として開発された GL570(LTCC)を用いて、Siとの相性を確認する為のシミュレーションを実施しました。
アンダーフィルリフロー時のセラミック基板反りに関する応力解析
製品イメージ
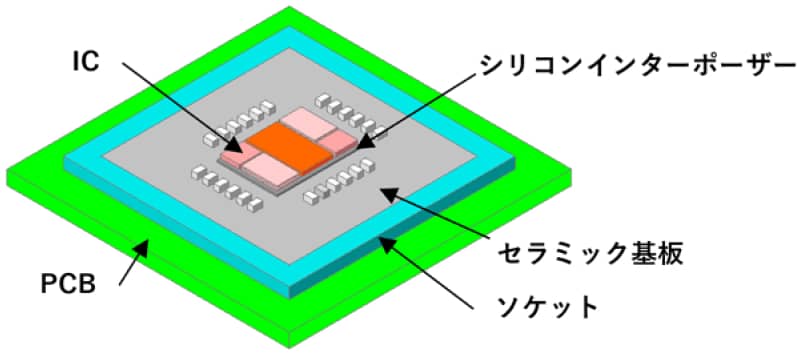
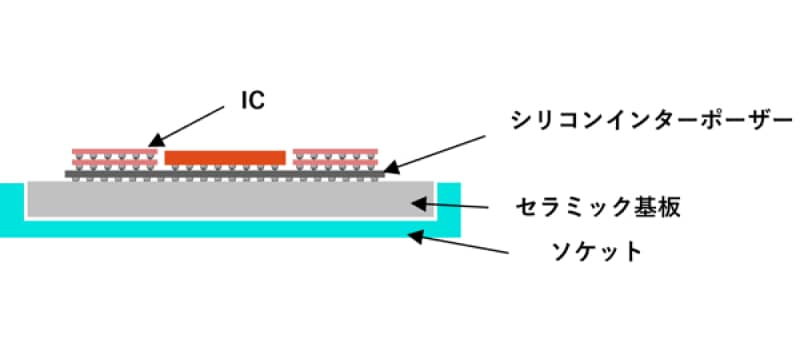
解析モデル
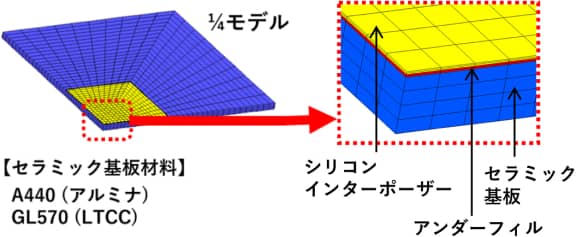
解析モデルサイズ
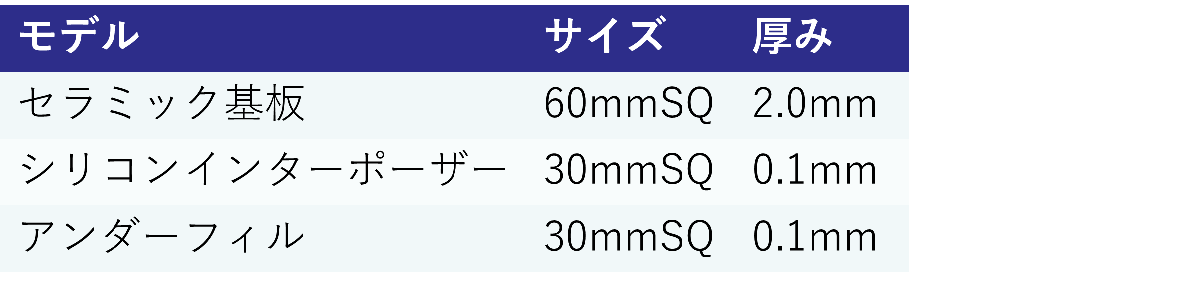
解析条件
150℃ -> 20℃(アンダーフィルキュア条件)
応力解析結果
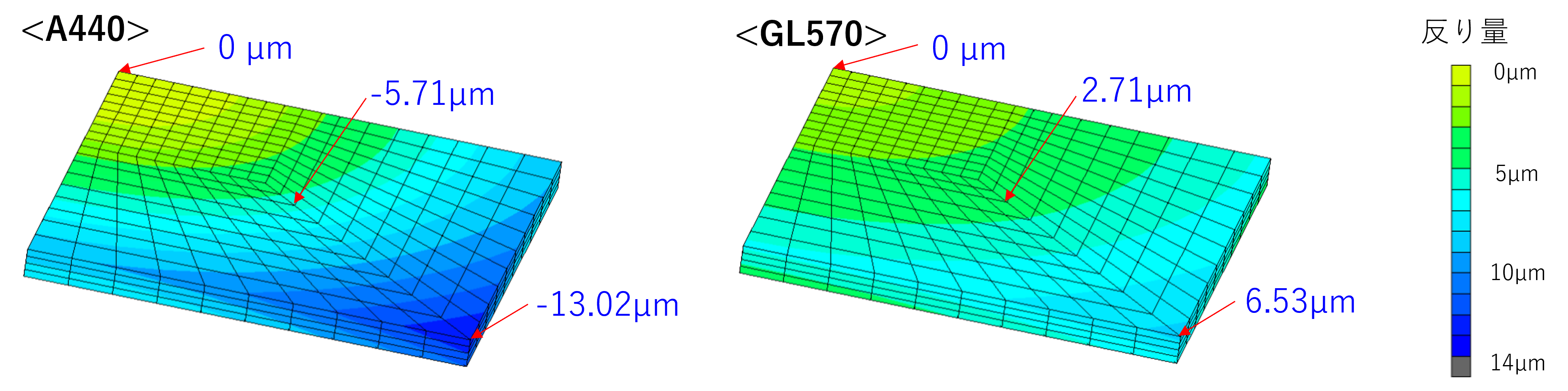
見解
シリコンインターポーザー(シリコン)の熱膨張係数に近い熱膨張係数を有するGL570基板では、基板反りが低減された事を確認。
上記は一例としてセラミック基板とシリコンインターポーザーの熱膨張係数差による反り・応力への影響を確認していますが、目的に応じて適切な材料を提案いたします。
「熱応力の緩和」を含む熱マネジメントのヒントはこちら
資料をダウンロード





