は行の用語
はんだフィレット
プリント配線とその上にはんだ実装された部品の外部端子との間にできるはんだの形状のこと。(下図参照)
LCCやSMDパッケージでは、キャスタレーションの側面メタライズ部はんだが流れ、フィレットが形成されることで、実装強度向上や、はんだ実装状態を目視で確認できる。
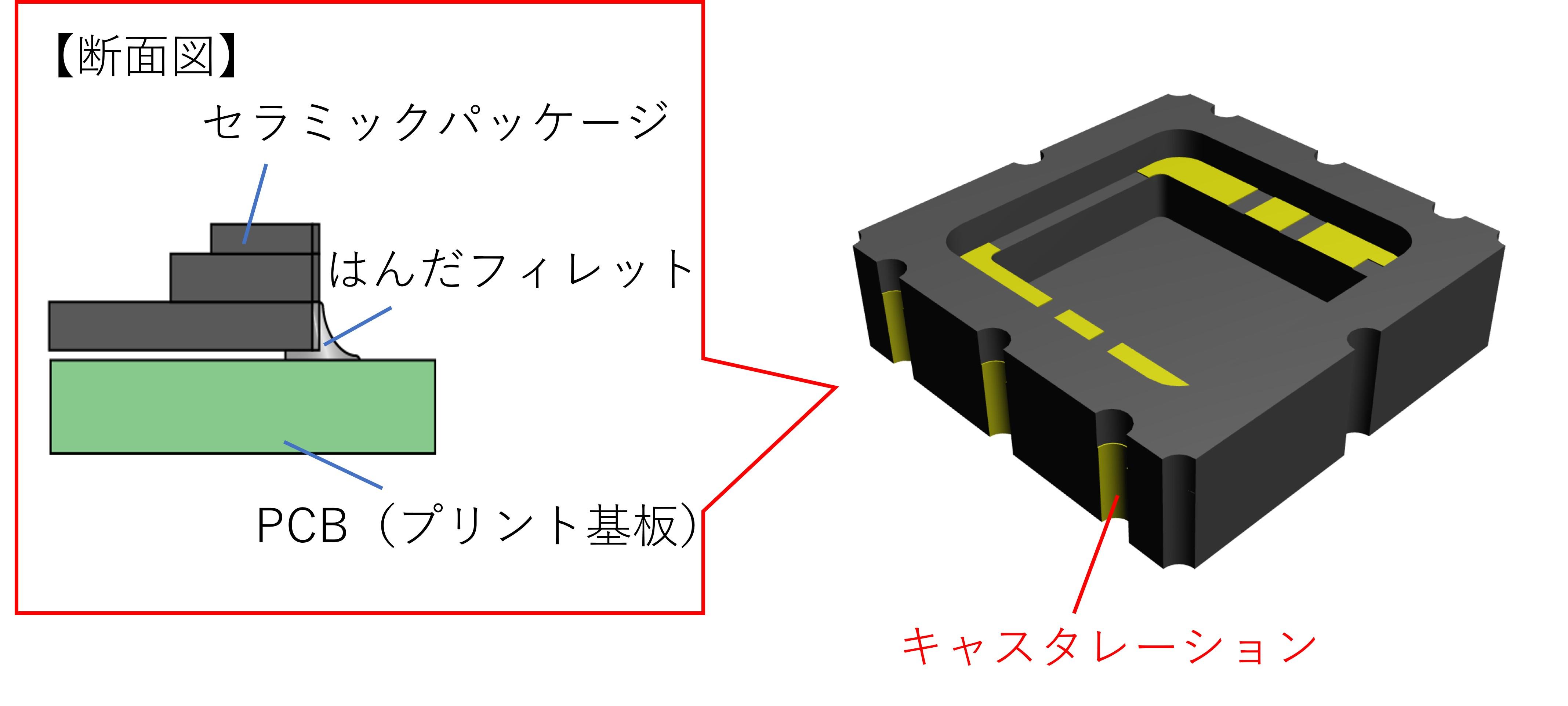
LCCやSMDパッケージでは、キャスタレーションの側面メタライズ部はんだが流れ、フィレットが形成されることで、実装強度向上や、はんだ実装状態を目視で確認できる。
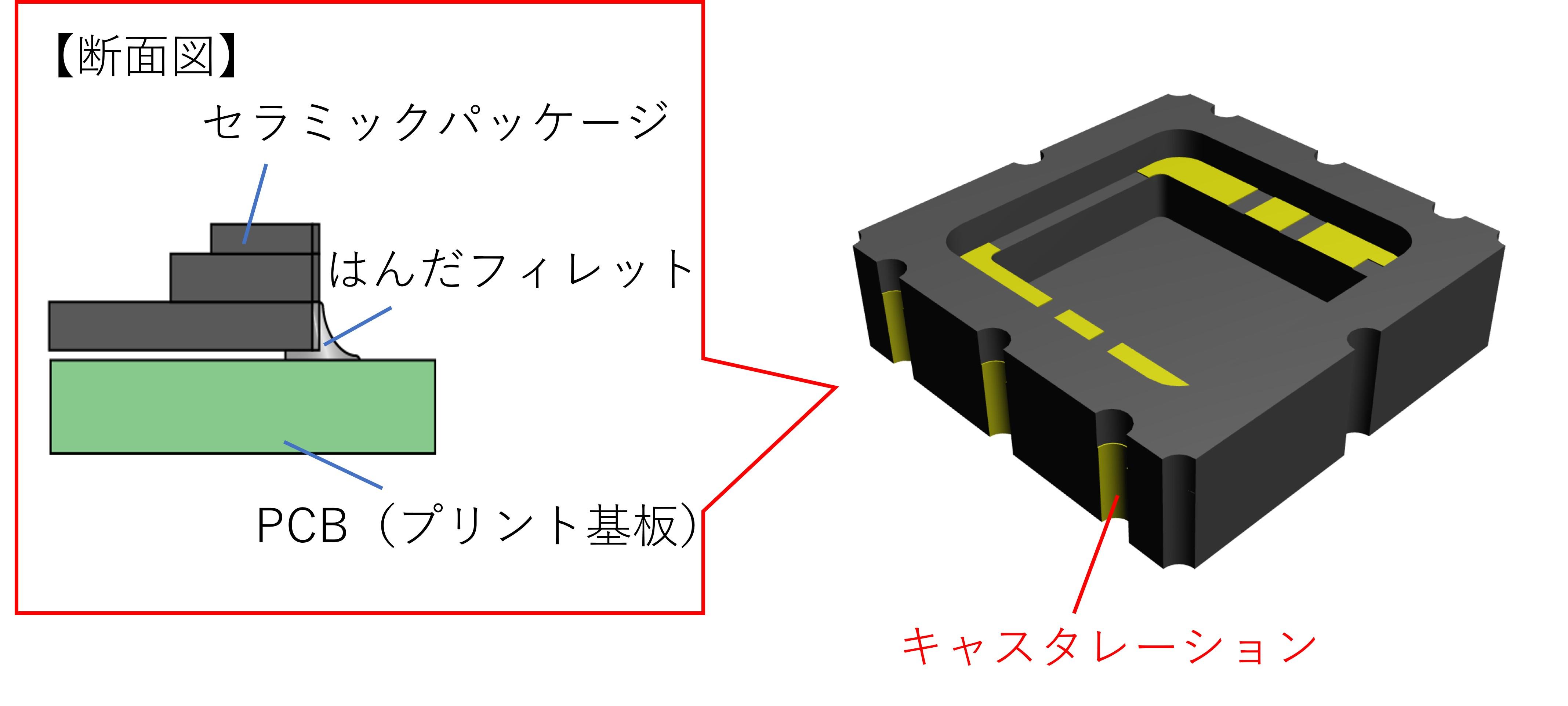
はんだ実装
はんだを使用して、プリント配線板に部品を搭載すること。
ハーメチックシール
気密封止のこと。高信頼性用途では素子の保護のため、シームウェルドなど気密度(水分や外気の侵入を防ぐ)の高い封止を行っている。気密性の低い封止のことをノンハーメチックシール、略してノンハーメと呼ぶこともある。
パルスレーザー
レーザー光がパルスとして発振されるレーザー。一定時間のパルスが周波数として繰り返し発信される。
パルス幅
一定の短い時間間隔で発生する信号の事をパルス信号と呼ぶ。パルス幅は、パルス信号の時間的な幅を表す。(下記図参照)
(パルス信号の一定の幅を持った矩形波のことで、パルスの立ち上がりからピークパワーの半値点と立ち下がりの半値点との間の時間間隔を指す。)
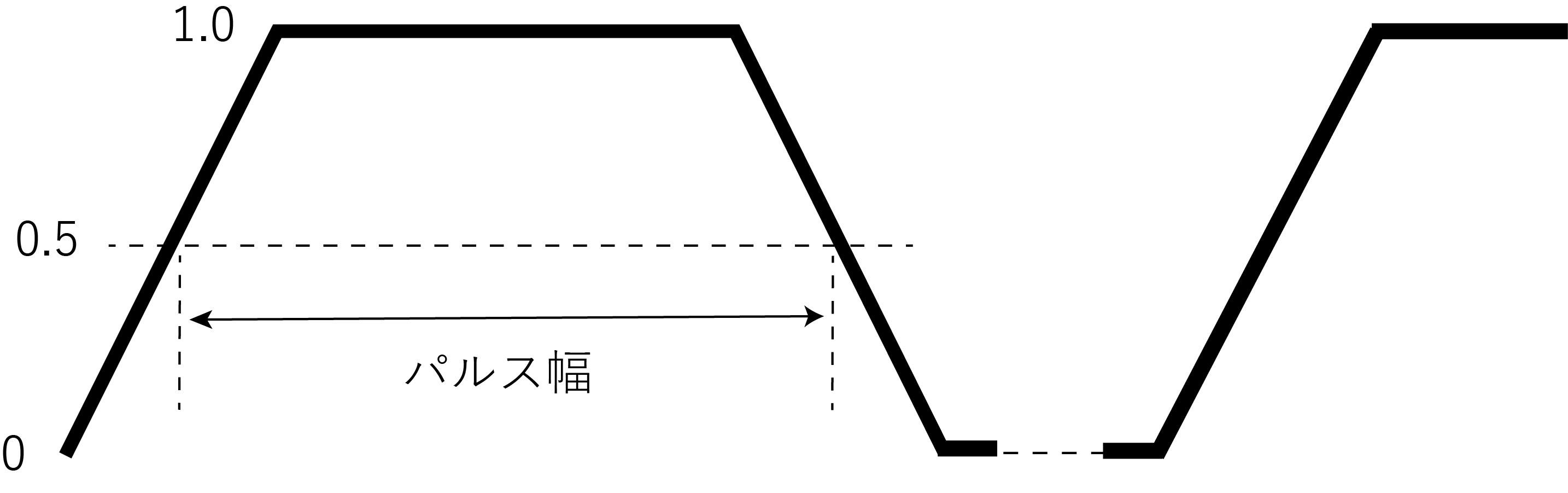
(パルス信号の一定の幅を持った矩形波のことで、パルスの立ち上がりからピークパワーの半値点と立ち下がりの半値点との間の時間間隔を指す。)
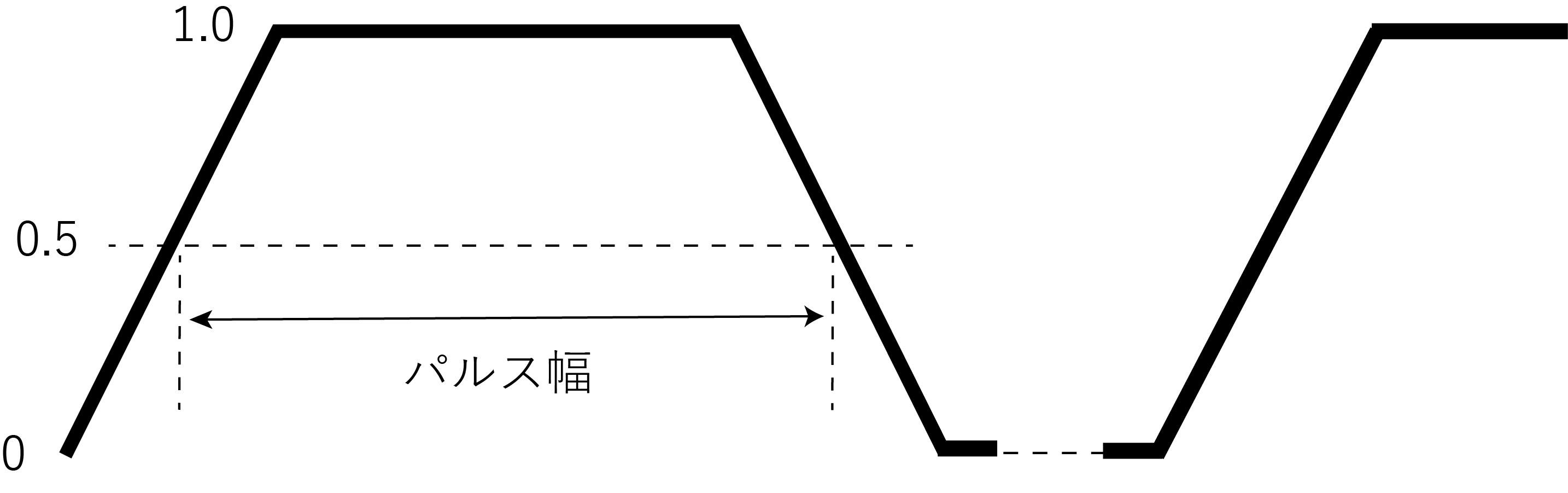
パーティクルカウンター
空気中や液体中に浮遊する微粒子の数や大きさを測定するための機械。
ヒートスプレッダー
半導体パッケージにおいて、素子から発生する熱を発散させるための高熱伝導の金属製構造部材。ヒートシンクとも呼ぶ。
ビア(VIA)
多層パッケージにおいて、層間の電気的導通を取るための穴。
セラミックパッケージは、ビアに電気導通用の導体が埋め込まれている。
セラミックパッケージは、ビアに電気導通用の導体が埋め込まれている。
ファインリークテスト
気密度を測定するための検査。ヘリウムリークディテクタ(リーク検出器)を用いて行う。
パッケージ単体で検査を行う場合は、下図のようにキャビティを反転させ、穴の上に被せ真空引きを行う。
その後周囲にHeガスを吹き付ける。気密不良個所があった場合、ディテクタでヘリウムが検出され、不良検出できる。
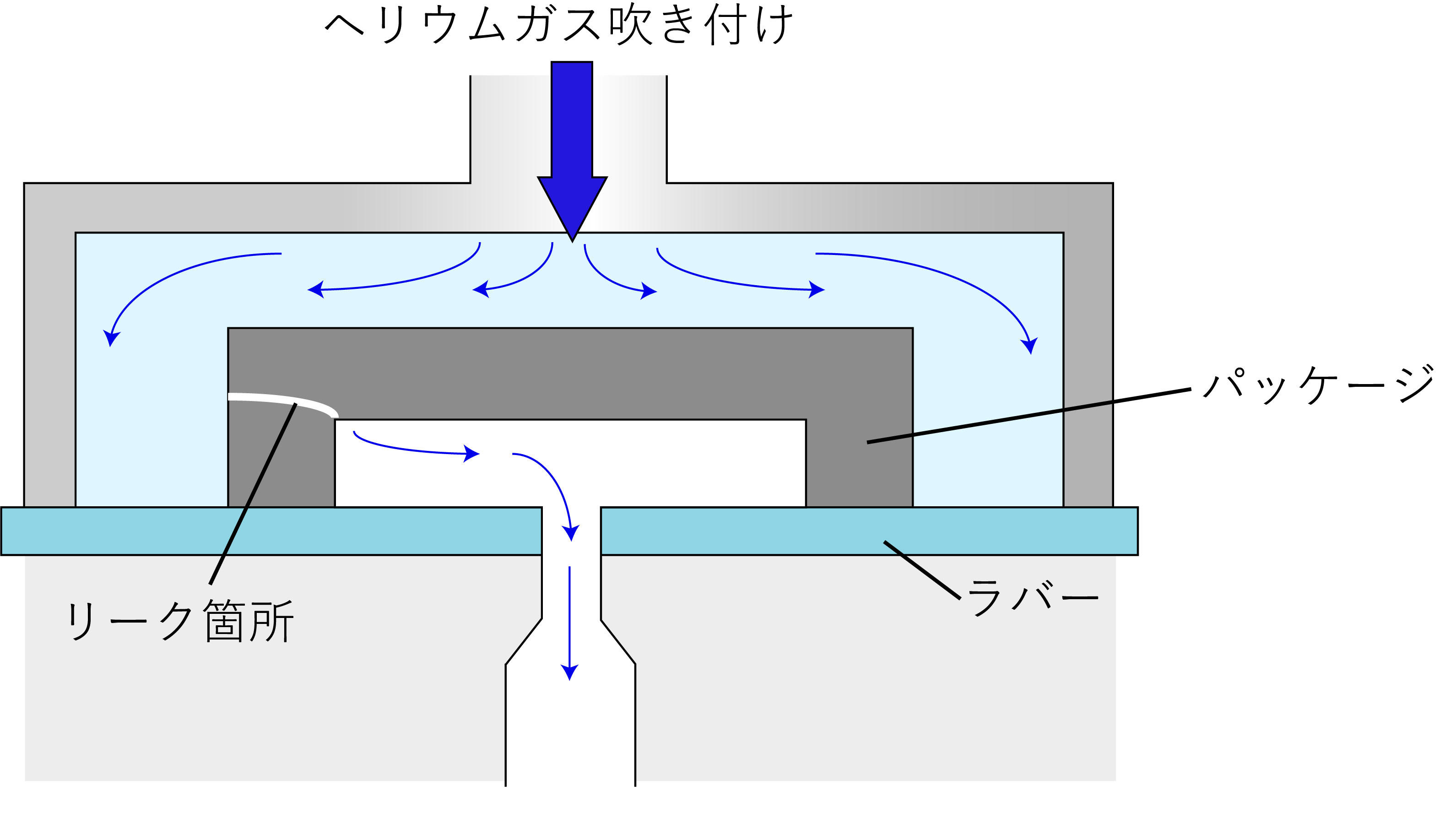
パッケージ単体で検査を行う場合は、下図のようにキャビティを反転させ、穴の上に被せ真空引きを行う。
その後周囲にHeガスを吹き付ける。気密不良個所があった場合、ディテクタでヘリウムが検出され、不良検出できる。
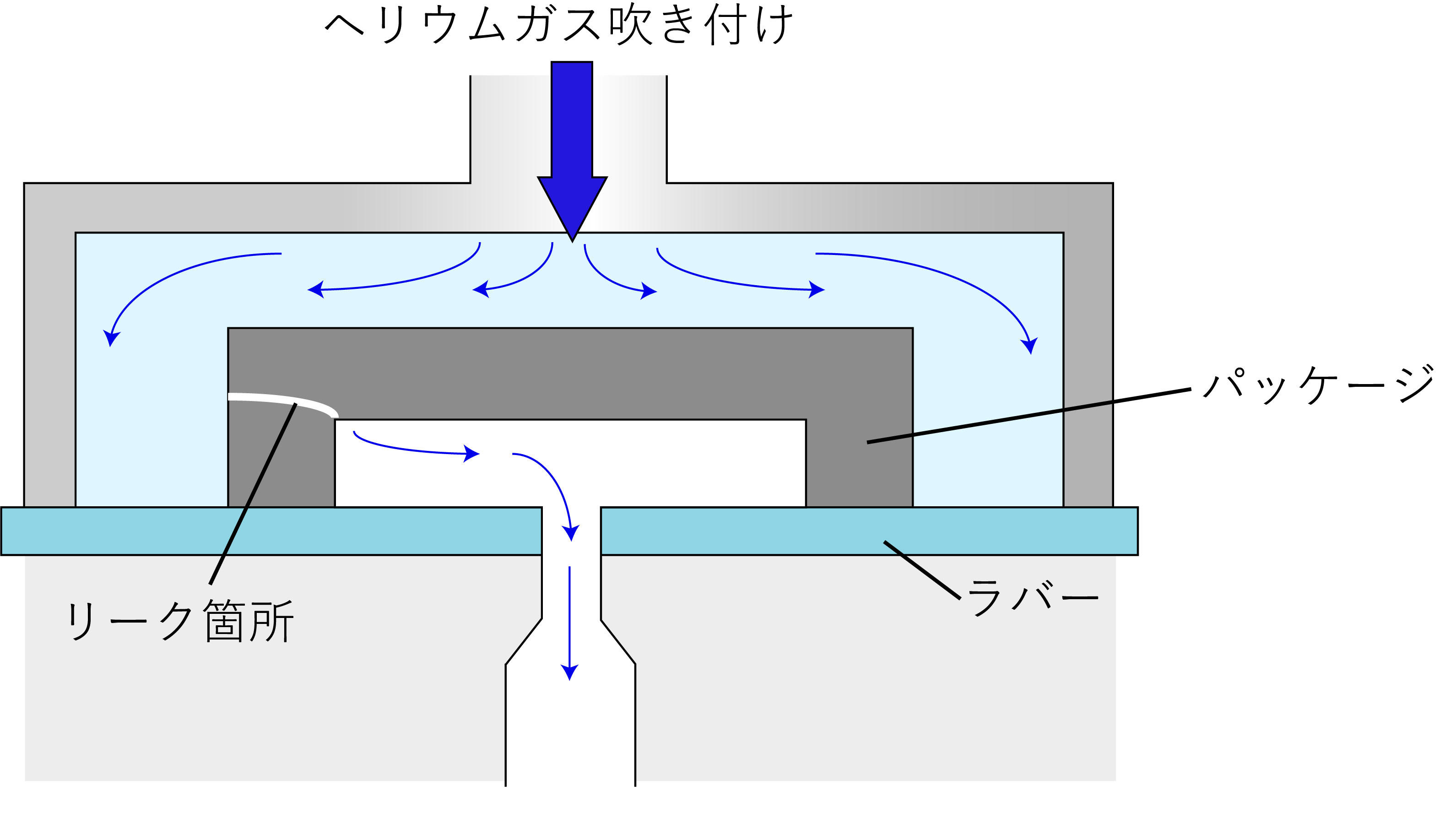
ベーキング
封止前に部品を加熱し、基板表面の水分を除去する工程。